【数码爱好者讯】从12nm开始,Intel的工艺推进速度似乎受到了“诅咒”,很难按照摩尔定律继续更新下去。Intel能做的就是不断打磨14nm工艺,以至于有好几代的处理器产品都是14nm工艺,当然每一代的性能都是有提升的,只是没有之前提升的幅度大而已。

到了10nm,这个“诅咒”也没有消除,Intel除了打磨10nm以更新产品外,还致力于开发7nm布局未来。当然,Intel的技术能力是非常强的,10nm工艺的芯片在数据上丝毫不输于台积电的7nm工艺。

尽管有这样傲人的成绩,但工艺迭代的落后是一个不争的事实。在Intel全力攻关7nm之时台积电的5nm已经量产,更先进的3nm工艺的研发也是进展顺利,按照计划2022年下半年就可大规模量产。设定的产能是每月5.5万片晶圆。但知情人士也透露,5.5万片是投产初期的月产能,随后就将逐步提升,2023年的月产能将提升到10万片晶圆。
Intel也没有那么“轴”,EMIB和Foveros等先进的封装技术让Intel可以在一个封装中使用多个不同的芯片,10nm、7nm、5nm甚至3nm的芯片都可以封装在一起。
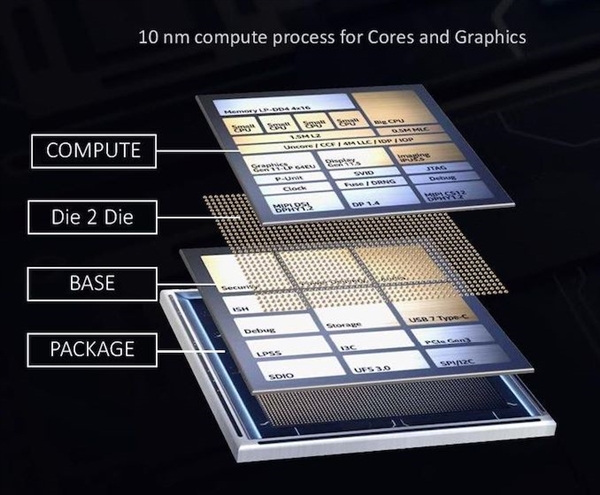
所以Intel会让第三方代工厂生产一部分采用更先进工艺的芯片(GPU)再结合自己生产的10nm工艺芯片封装成全新一代的处理器产品。
实时似乎正在朝这个方向发展,据外媒最新消息,Intel已经将2021年的18万片晶圆GPU的代工订单交给了台积电,用6nm工艺生产。除此之外,台积电尚未投产的3nm工艺也将会获得Intel的订单。

另外,Intel还可能会选择采用EMIB和Foveros等先进的封装技术,该技术允许在一个封装中使用多个不同的芯片。由第三方晶圆厂生产7nm甚至5nm的部分芯片,再通过先进的封装技术将之与自己生产的12nm、10nm工艺的部分芯片组合起来。目前,这一技术已经在Kaby Lake-G和新的Core-Lakefield处理器产品中使用。这样的混合封装方案既能够匹配Intel既定的工艺节点又可以将主要的制造握在自己的手里。
大小芯片混合封装的产品路线对于Intel来说至关重要,也是其未来产品的必然趋势。而Intel要做的就是衡量小芯片的生产有多少依靠第三方晶圆厂,有多少自己来造。






